Reflow soldadura soldadura-pasta bat (hautsezko soldadura eta fluxuaren nahasketa itsaskorra) erabiltzen den prozesu bat da, osagai elektriko bat edo batzuk haien kontaktu-zatietan aldi baterako eransteko, eta, ondoren, multzo osoa bero kontrolatua jasaten da, eta horrek soldadura urtzen du. , juntadura betirako lotuz.Berotzea lor daiteke muntaia errefluxu-labe batetik edo infragorrien lanpara baten azpian pasatuz edo banakako junturak aire beroko arkatz batekin soldatuz.
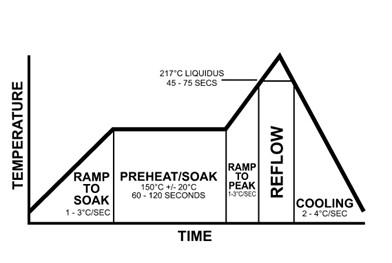
Reflow soldadura gainazaleko muntatzeko osagaiak zirkuitu plakari eransteko metodorik ohikoena da, nahiz eta zuloen osagaietarako ere erabil daitekeen, zuloak soldadura-pastaz betez eta osagaien kateak itsatsitik sartuz.Uhin-soldadura sinpleagoa eta merkeagoa izan daitekeenez, errefluxua ez da normalean zulo bidezko taula hutsetan erabiltzen.SMT eta THT osagaien nahasketa duten tauletan erabiltzen denean, zulo bidezko birfluxuak uhinen soldadura urratsa muntaketa prozesutik kentzea ahalbidetzen du, muntaketa kostuak murrizteko.
Reflow prozesuaren helburua soldadura urtzea eta ondoko gainazalak berotzea da, osagai elektrikoak gehiegi berotu eta kaltetu gabe.Ohiko reflow soldadura-prozesuan, normalean, lau fase egon ohi dira, "zona" izenekoak, bakoitzak profil termiko desberdina duena: aurrez berotzea, beratzen termikoa (askotan beratzen bakarrik laburtua), birfluxua eta hoztea.
Aurrez berotu zona
Gehieneko malda tenperatura/denbora erlazioa da, zirkuitu inprimatuko plakan tenperatura zenbateraino aldatzen den neurtzen duena.Aurreberotze-eremua askotan zonaldeetan luzeena da eta askotan arrapala-tasa ezartzen du.Igoera-tasa 1,0 °C eta 3,0 °C artekoa izan ohi da segundoko, askotan 2,0 °C eta 3,0 °C (4 °F eta 5 °F) segundoko.Tasa gehienezko malda gainditzen badu, kolpe termiko edo pitzaduragatik osagaiak kalteak gerta daitezke.
Soldadura-pastak zipriztin-efektua ere izan dezake.Aurreberotze-atalean pastako disolbatzailea lurruntzen hasten da, eta igoera-tasa (edo tenperatura-maila) baxuegia bada, fluxu lurrunkorren lurrunketa osatu gabe dago.
Bertze termikoko gunea
Bigarren atala, beratze termikoa, normalean 60 eta 120 segundo arteko esposizioa izaten da soldadura-pasta lurrunkorrak kentzeko eta fluxuak aktibatzeko (ikus fluxua), non fluxuaren osagaiak osagaien berunetan eta padetan oxidatzen hasten diren.Tenperatura altuegiak soldadura zipriztintzea edo bola egitea ekar dezake, baita orearen, eranskinen eta osagaien amaierak oxidatzea ere.
Era berean, baliteke fluxuak guztiz aktibatzea tenperatura baxuegia bada.Beratze-eremuaren amaieran, muntaketa osoaren oreka termikoa nahi da errefluxu-eremuaren aurretik.Bertze-profila iradokitzen da tamaina desberdinetako osagaien artean edozein delta T gutxitzeko edo PCB-en muntaia oso handia bada.Bertze profil bat ere gomendatzen da eremu-matrize motako paketeetan hutsunea murrizteko.
Errefluxu eremua
Hirugarren atala, errefluxu-eremua, "erreflow gaineko denbora" edo "liquidus gainetik denbora" (TAL) deitzen zaio, eta tenperatura maximoa lortzen den prozesuaren zatia da.Kontu garrantzitsu bat tenperatura gailurra da, hau da, prozesu osoaren onar daitekeen tenperatura maximoa.Tenperatura gailur arrunta likidusaren gainetik 20-40 °C-koa da. Muga hori tenperatura altuetarako tolerantziarik txikiena duen muntaian dagoen osagaiak zehazten du (kalte termikoak jasan ditzakeen osagaia).Jarraibide estandar bat osagai ahulenak jasan dezakeen tenperatura maximoari 5 °C kentzea da prozesurako tenperatura maximora iristeko.Garrantzitsua da prozesuaren tenperatura kontrolatzea muga hori gaindi ez dezan.
Gainera, tenperatura altuek (260 °C-tik gorakoak) SMT osagaien barneko trokeletan kalteak eragin ditzakete, baita metalen arteko hazkuntza sustatu ere.Aitzitik, nahikoa beroa ez den tenperaturak pasta behar bezala itzultzea eragotzi dezake.
Liquidus gaineko denborak (TAL), edo errefluxuaren gaineko denborak, soldadura likidoa zenbat denbora den neurtzen du.Fluxuak metalen junturan gainazaleko tentsioa murrizten du metalurgia lotura lortzeko, soldadura hauts esferak konbinatzeko aukera emanez.Profil-denborak fabrikatzailearen zehaztapena gainditzen badu, emaitza fluxua goiztiarra aktibatzea edo kontsumoa izan daiteke, orea eraginkortasunez "lehortuz" soldadura-juntura eratu aurretik.Denbora/tenperatura erlazio nahikorik ezak fluxuaren garbiketa-ekintzaren murrizketa eragiten du, eta ondorioz, bustidura eskasa, disolbatzailea eta fluxua ezabatzea desegokia eta baliteke soldadura-juntura akastunak eragiten ditu.
Adituek normalean ahalik eta TAL laburrena gomendatzen dute, hala ere, pasta gehienek 30 segundoko gutxieneko TAL bat zehazten dute, denbora zehatz horretarako arrazoi argirik ez dagoen arren.Aukera bat da PCBan profila egitean neurtzen ez diren tokiak egotea, eta, beraz, baimendutako gutxieneko denbora 30 segundotan ezartzeak neurtu gabeko eremu bat berriro isurtzeko aukerak murrizten ditu.Gutxieneko errefluxu-denbora altu batek labearen tenperatura-aldaketen aurkako segurtasun-tartea ere eskaintzen du.Hezetze-denbora likidusaren gainetik 60 segundo baino gutxiago egon da.Liquidus gainetik denbora gehigarriak metalen arteko gehiegizko hazkuntza eragin dezake, eta horrek artikulazioen hauskortasuna ekar dezake.Taula eta osagaiak denbora luzez hondatu daitezke liquidus baino gehiago, eta osagai gehienek ondo zehaztutako denbora-muga dute gehienezko tenperaturaren eraginpean egon daitezkeen denborarako.
Liquidus gainetik denbora gutxiegiak disolbatzaileak eta fluxua harrapatzen ditu eta juntura hotzak edo aspergarriak eta soldadura hutsuneak sor ditzake.
Hozte-gunea
Azken gunea hozte gune bat da, prozesatutako taula pixkanaka hozteko eta soldadura-junturak sendotzeko.Hozte egokiak osagaien gehiegizko formazio intermetalikoa edo shock termikoa galarazten du.Hozte guneko tenperatura tipikoak 30-100 °C bitartekoak dira (86-212 °F).Hozte-abiadura azkarra aukeratzen da mekanikoki sendoena den ale finko egitura bat sortzeko.
[1] Gehienezko igoera-tasa ez bezala, sarri-jaitsiera-tasa baztertu egiten da.Baliteke arrapala-tasa ez hain kritikoa izatea tenperatura batzuetatik gora, hala ere, edozein osagairi onartzen den gehieneko malda aplikatu beharko litzateke osagaia berotzen edo hozten ari den ala ez.4°C/s-ko hozte-abiadura iradokitzen da normalean.Prozesuaren emaitzak aztertzerakoan kontuan hartu beharreko parametroa da.
"Reflow" terminoa soldadura-aleazio-masa solido bat urtuko den tenperaturari erreferentzia egiteko erabiltzen da (leundu besterik ez bezala).Tenperatura horretatik behera hozten bada, soldadura ez da isuriko.Bere gainetik berotuta, soldadura berriro isuriko da, beraz, "berre-fluxua".
Reflow soldadura erabiltzen duten zirkuituen muntaketa teknika modernoek ez dute zertan soldadura behin baino gehiagotan isurtzen uzten.Soldadura-pastean jasotako soldadura pikordunak inplikatutako soldaduraren errefluxuaren tenperatura gainditzen duela bermatzen dute.
Profilatze termikoa

Profil termiko baterako Prozesuaren Leihoaren Indizearen irudikapen grafikoa.
Elektronikako fabrikazio-industrian, prozesu termiko baten sendotasuna kuantifikatzeko prozesu-leihoaren indizea (PWI) izenez ezagutzen den neurri estatistiko bat erabiltzen da.PWI-k prozesu bat zenbateraino egokitzen den neurtzen laguntzen du erabiltzaileak definitutako prozesu-muga gisa ezagutzen den Zehaztapenaren Muga. Profil termiko bakoitza prozesu-leiho batean "egokitzen" den arabera sailkatzen da (zehaztapen edo tolerantzia muga).
Prozesu-leihoaren erdigunea zero gisa definitzen da, eta prozesu-leihoaren muturreko ertza % 99 gisa. PWI % 100 baino handiagoa edo berdina den batek adierazten du profilak ez duela produktua zehaztapenen barruan prozesatzen.% 99ko PWI batek adierazten du profilak produktua zehaztapenen barruan prozesatzen duela, baina prozesuaren leihoaren ertzean exekutatzen dela.%60ko PWI batek adierazten du profil batek prozesuaren zehaztapenaren %60 erabiltzen duela.PWI balioak erabiliz, fabrikatzaileek profil termiko jakin batek prozesu-leihotik zenbat erabiltzen duen zehaztu dezakete.PWI balio txikiagoak profil sendoagoa adierazten du.
Eraginkortasun handiena lortzeko, PWI balio bereiziak kalkulatzen dira profil termiko baten gailurra, malda, birfluxua eta beratzen prozesuetarako.Irteeran kolpe termikoak eragin dezakeen aukera saihesteko, profil termikoko maldarik gogorrena zehaztu eta berdindu behar da.Fabrikatzaileek neurrira egindako softwarea erabiltzen dute maldaren aldapa zehaztasunez zehazteko eta murrizteko.Horrez gain, softwareak automatikoki birkalibratzen ditu PWI balioak gailurra, malda, birfluxua eta beratzen prozesuetarako.PWI balioak ezarriz, ingeniariek bermatu dezakete reflow soldadura lana ez dela gehiegi berotzen edo azkarregi hozten.
Argitalpenaren ordua: 2022-01-01

