Reflow soldering ແມ່ນຂະບວນການທີ່ເຄື່ອງ solder paste (ປະສົມຫນຽວຂອງ solder ຜົງແລະ flux) ຖືກນໍາໃຊ້ເພື່ອຕິດຫນຶ່ງຫຼືຫຼາຍອົງປະກອບໄຟຟ້າຊົ່ວຄາວກັບແຜ່ນຕິດຕໍ່ຂອງເຂົາເຈົ້າ, ຫຼັງຈາກນັ້ນການປະກອບທັງຫມົດແມ່ນຂຶ້ນກັບຄວາມຮ້ອນຄວບຄຸມ, ຊຶ່ງເຮັດໃຫ້ solder melts. , ຖາວອນເຊື່ອມຕໍ່ຮ່ວມກັນ.ການໃຫ້ຄວາມຮ້ອນອາດຈະເຮັດໄດ້ໂດຍການຖ່າຍທອດການປະກອບຜ່ານເຕົາອົບ reflow ຫຼືພາຍໃຕ້ໂຄມໄຟ infrared ຫຼືໂດຍການ soldering ຂໍ້ຕໍ່ບຸກຄົນດ້ວຍ pencil ອາກາດຮ້ອນ.
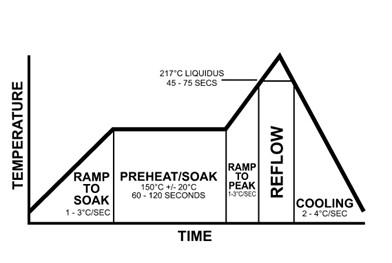
Reflow soldering ແມ່ນວິທີການທົ່ວໄປທີ່ສຸດຂອງການຕິດອົງປະກອບ mount ດ້ານກັບກະດານວົງຈອນ, ເຖິງແມ່ນວ່າມັນຍັງສາມາດຖືກນໍາໃຊ້ສໍາລັບອົງປະກອບຜ່ານຮູໂດຍການຕື່ມຮູດ້ວຍ solder paste ແລະໃສ່ອົງປະກອບນໍາໄປສູ່ການວາງ.ເນື່ອງຈາກວ່າການ soldering ຄື້ນສາມາດງ່າຍດາຍແລະລາຄາຖືກກວ່າ, reflow ໂດຍທົ່ວໄປບໍ່ໄດ້ຖືກນໍາໃຊ້ໃນກະດານຜ່ານຂຸມບໍລິສຸດ.ເມື່ອນໍາໃຊ້ໃນກະດານທີ່ປະກອບດ້ວຍສ່ວນປະກອບຂອງ SMT ແລະ THT, ການໄຫຼວຽນຜ່ານຮູຊ່ວຍໃຫ້ຂັ້ນຕອນການເຊື່ອມຂອງຄື້ນຖືກກໍາຈັດອອກຈາກຂະບວນການປະກອບ, ເຊິ່ງອາດຈະຫຼຸດລົງຄ່າໃຊ້ຈ່າຍໃນການປະກອບ.
ເປົ້າຫມາຍຂອງຂະບວນການ reflow ແມ່ນການລະລາຍ solder ແລະເຮັດໃຫ້ຄວາມຮ້ອນຂອງຫນ້າດິນຕິດກັນ, ໂດຍບໍ່ມີການ overheating ແລະທໍາລາຍອົງປະກອບໄຟຟ້າ.ໃນຂະບວນການ soldering reflow ທໍາມະດາ, ປົກກະຕິແລ້ວມີສີ່ຂັ້ນຕອນ, ເອີ້ນວ່າ "ເຂດ", ແຕ່ລະຄົນມີໂປຣໄຟລ໌ຄວາມຮ້ອນທີ່ແຕກຕ່າງກັນ: preheat, ແຊ່ຄວາມຮ້ອນ (ມັກຈະສັ້ນພຽງແຕ່ແຊ່), reflow, ແລະຄວາມເຢັນ.
Preheat ເຂດ
ຄວາມຊັນສູງສຸດແມ່ນຄວາມສຳພັນຂອງອຸນຫະພູມ/ເວລາ ທີ່ວັດແທກຄວາມໄວຂອງອຸນຫະພູມຢູ່ໃນແຜ່ນວົງຈອນພິມໄດ້ປ່ຽນແປງ.ເຂດ preheat ມັກຈະເປັນເຂດທີ່ຍາວທີ່ສຸດຂອງເຂດແລະມັກຈະສ້າງອັດຕາການລ້າ.ອັດຕາການທາງຂຶ້ນໂດຍປົກກະຕິແມ່ນບາງບ່ອນລະຫວ່າງ 1.0 ° C ແລະ 3.0 ° C ຕໍ່ວິນາທີ, ມັກຈະຫຼຸດລົງລະຫວ່າງ 2.0 ° C ແລະ 3.0 ° C (4 ° F ຫາ 5 ° F) ຕໍ່ວິນາທີ.ຖ້າອັດຕາເກີນຄວາມຊັນສູງສຸດ, ຄວາມເສຍຫາຍຕໍ່ອົງປະກອບຈາກການຊ໊ອກຄວາມຮ້ອນຫຼືຮອຍແຕກສາມາດເກີດຂື້ນໄດ້.
Solder paste ຍັງສາມາດມີຜົນກະທົບ spattering.ພາກສ່ວນ preheat ແມ່ນບ່ອນທີ່ solvent ໃນ paste ເລີ່ມລະເຫີຍ, ແລະຖ້າຫາກວ່າອັດຕາການເພີ່ມຂຶ້ນ (ຫຼືລະດັບອຸນຫະພູມ) ຕ່ໍາເກີນໄປ, ການລະເຫີຍຂອງ flux volatiles ແມ່ນບໍ່ສົມບູນ.
ເຂດແຊ່ຄວາມຮ້ອນ
ພາກສ່ວນທີສອງ, ການແຊ່ຄວາມຮ້ອນ, ໂດຍທົ່ວໄປແລ້ວແມ່ນການສໍາຜັດ 60 ຫາ 120 ວິນາທີສໍາລັບການໂຍກຍ້າຍຂອງ solder paste volatiles ແລະການກະຕຸ້ນຂອງ fluxes ໄດ້ (ເບິ່ງ flux), ບ່ອນທີ່ອົງປະກອບ flux ເລີ່ມຕົ້ນການຫຼຸດຜ່ອນການອອກໄຊຂອງສ່ວນນໍາແລະ pads.ອຸນຫະພູມສູງເກີນໄປສາມາດນໍາໄປສູ່ການ spattering solder ຫຼືບານເຊັ່ນດຽວກັນກັບການຜຸພັງຂອງການນໍາ, pads ຕິດແລະການສິ້ນສ່ວນ.
ເຊັ່ນດຽວກັນ, fluxes ອາດຈະບໍ່ເປີດໃຊ້ຢ່າງເຕັມທີ່ຖ້າຫາກວ່າອຸນຫະພູມຕ່ໍາເກີນໄປ.ໃນຕອນທ້າຍຂອງເຂດແຊ່, ຄວາມສົມດຸນຂອງຄວາມຮ້ອນຂອງອຸປະກອນທັງຫມົດແມ່ນຕ້ອງການກ່ອນເຂດ reflow.A ແຊ່ profile ແມ່ນແນະນໍາໃຫ້ຫຼຸດລົງ delta T ໃດໆລະຫວ່າງອົງປະກອບຂອງຂະຫນາດທີ່ແຕກຕ່າງກັນຫຼືຖ້າຫາກວ່າການປະກອບ PCB ມີຂະຫນາດໃຫຍ່ຫຼາຍ.ໂປຣໄຟລແຊ່ແມ່ນຍັງແນະນໍາໃຫ້ຫຼຸດຜ່ອນ voiding ໃນຊຸດປະເພດ array ພື້ນທີ່.
ເຂດ Reflow
ພາກທີສາມ, ເຂດ reflow, ຍັງເອີ້ນວ່າ "ເວລາຂ້າງເທິງ reflow" ຫຼື "ເວລາຂ້າງເທິງ liquidus" (TAL), ແລະເປັນສ່ວນຫນຶ່ງຂອງຂະບວນການທີ່ອຸນຫະພູມສູງສຸດແມ່ນບັນລຸໄດ້.ການພິຈາລະນາທີ່ສໍາຄັນແມ່ນອຸນຫະພູມສູງສຸດ, ເຊິ່ງເປັນອຸນຫະພູມສູງສຸດທີ່ອະນຸຍາດຂອງຂະບວນການທັງຫມົດ.ອຸນຫະພູມສູງສຸດທົ່ວໄປແມ່ນ 20-40 ° C ຂ້າງເທິງ liquidus. ຂອບເຂດຈໍາກັດນີ້ຖືກກໍານົດໂດຍອົງປະກອບກ່ຽວກັບການປະກອບທີ່ມີຄວາມທົນທານຕ່ໍາສຸດສໍາລັບອຸນຫະພູມສູງ (ອົງປະກອບທີ່ອ່ອນໄຫວຕໍ່ກັບຄວາມເສຍຫາຍຄວາມຮ້ອນທີ່ສຸດ).ບົດແນະນໍາມາດຕະຖານແມ່ນເພື່ອລົບ 5 °C ຈາກອຸນຫະພູມສູງສຸດທີ່ອົງປະກອບທີ່ມີຄວາມສ່ຽງທີ່ສຸດສາມາດຮັກສາໄວ້ຈົນກ່ວາອຸນຫະພູມສູງສຸດສໍາລັບຂະບວນການ.ມັນເປັນສິ່ງສໍາຄັນທີ່ຈະຕິດຕາມອຸນຫະພູມຂະບວນການເພື່ອຮັກສາມັນບໍ່ໃຫ້ເກີນຂອບເຂດຈໍາກັດນີ້.
ນອກຈາກນັ້ນ, ອຸນຫະພູມສູງ (ເກີນ 260 ° C) ອາດຈະເຮັດໃຫ້ເກີດຄວາມເສຍຫາຍຕໍ່ການຕາຍພາຍໃນຂອງອົງປະກອບ SMT ເຊັ່ນດຽວກັນກັບການຂະຫຍາຍຕົວຂອງ intermetallic.ໃນທາງກັບກັນ, ອຸນຫະພູມທີ່ບໍ່ຮ້ອນພຽງພໍອາດຈະປ້ອງກັນບໍ່ໃຫ້ paste ໄຫລຄືນຢ່າງພຽງພໍ.
ເວລາຂ້າງເທິງ liquidus (TAL), ຫຼືເວລາຂ້າງເທິງ reflow, ວັດແທກໄລຍະເວລາຂອງ solder ເປັນຂອງແຫຼວ.flux ຫຼຸດຜ່ອນຄວາມກົດດັນດ້ານໃນຈຸດເຊື່ອມຕໍ່ຂອງໂລຫະເພື່ອເຮັດສໍາເລັດການຜູກມັດໂລຫະ, ອະນຸຍາດໃຫ້ແຕ່ລະແຜ່ນ solder ຝຸ່ນປະສົມ.ຖ້າເວລາ profile ເກີນຂໍ້ກໍານົດຂອງຜູ້ຜະລິດ, ຜົນໄດ້ຮັບອາດຈະເປັນການກະຕຸ້ນຫຼືການບໍລິໂພກຂອງ flux ກ່ອນໄວອັນຄວນ, ປະສິດທິຜົນ "ຕາກໃຫ້ແຫ້ງ" ກ່ອນທີ່ຈະສ້າງຕັ້ງຂອງຮ່ວມກັນ solder.ການພົວພັນເວລາ / ອຸນຫະພູມບໍ່ພຽງພໍເຮັດໃຫ້ການປະຕິບັດການເຮັດຄວາມສະອາດຂອງ flux ຫຼຸດລົງ, ເຮັດໃຫ້ເກີດຄວາມຊຸ່ມຊື່ນທີ່ບໍ່ດີ, ການໂຍກຍ້າຍອອກບໍ່ພຽງພໍຂອງສານລະລາຍແລະ flux, ແລະອາດຈະເປັນຂໍ້ບົກພ່ອງຂອງຂໍ້ຕໍ່ solder.
ຜູ້ຊ່ຽວຊານປົກກະຕິແລ້ວແນະນໍາ TAL ທີ່ສັ້ນທີ່ສຸດທີ່ເປັນໄປໄດ້, ຢ່າງໃດກໍຕາມ, pastes ສ່ວນໃຫຍ່ກໍານົດ TAL ຕໍາ່ສຸດທີ່ 30 ວິນາທີ, ເຖິງແມ່ນວ່າເບິ່ງຄືວ່າບໍ່ມີເຫດຜົນທີ່ຊັດເຈນສໍາລັບເວລາສະເພາະນັ້ນ.ຄວາມເປັນໄປໄດ້ຫນຶ່ງແມ່ນວ່າມີສະຖານທີ່ຢູ່ໃນ PCB ທີ່ບໍ່ໄດ້ຖືກວັດແທກໃນລະຫວ່າງການສ້າງໂປຣໄຟລ໌, ແລະດັ່ງນັ້ນ, ການກໍານົດເວລາທີ່ອະນຸຍາດໃຫ້ຕໍາ່ສຸດທີ່ 30 ວິນາທີຈະຫຼຸດຜ່ອນໂອກາດຂອງພື້ນທີ່ທີ່ບໍ່ໄດ້ວັດແທກບໍ່ reflowing.ເວລາ reflow ຕໍາ່ສຸດທີ່ສູງຍັງສະຫນອງຂອບຂອງຄວາມປອດໄພຕໍ່ກັບການປ່ຽນແປງອຸນຫະພູມເຕົາອົບ.ເວລາປຽກຊຸ່ມຢ່າງເໝາະສົມຈະຢູ່ຕໍ່າກວ່າ 60 ວິນາທີ ຂ້າງເທິງຂອງແຫຼວ.ເວລາເພີ່ມເຕີມຂ້າງເທິງ liquidus ອາດຈະເຮັດໃຫ້ການຂະຫຍາຍຕົວ intermetallic ຫຼາຍເກີນໄປ, ຊຶ່ງສາມາດນໍາໄປສູ່ການ brittleness ຮ່ວມກັນ.ກະດານແລະອົງປະກອບອາດຈະຖືກທໍາລາຍໃນເວລາຕໍ່ເວລາເກີນຂອງ liquidus, ແລະອົງປະກອບສ່ວນໃຫຍ່ມີກໍານົດເວລາທີ່ກໍານົດໄວ້ດີສໍາລັບໄລຍະເວລາທີ່ພວກມັນອາດຈະຖືກອຸນຫະພູມສູງກວ່າລະດັບສູງສຸດທີ່ກໍານົດໄວ້.
ເວລາຫນ້ອຍເກີນໄປຂ້າງເທິງຂອງ liquidus ອາດຈະຕິດສານລະລາຍແລະ flux ແລະສ້າງທ່າແຮງສໍາລັບຂໍ້ຕໍ່ເຢັນຫຼືຈືດໆເຊັ່ນດຽວກັນກັບ solder voids.
ເຂດເຮັດຄວາມເຢັນ
ເຂດສຸດທ້າຍແມ່ນເຂດເຮັດຄວາມເຢັນເພື່ອຄ່ອຍໆເຢັນກະດານທີ່ປຸງແຕ່ງແລະແຂງຂອງຂໍ້ຕໍ່ solder.ຄວາມເຢັນທີ່ເຫມາະສົມ inhibits ການສ້າງ intermetallic ເກີນຫຼືການຊ໊ອກຄວາມຮ້ອນກັບອົງປະກອບ.ອຸນຫະພູມປົກກະຕິໃນເຂດຄວາມເຢັນລະຫວ່າງ 30–100°C (86–212°F).ອັດຕາຄວາມເຢັນໄວແມ່ນຖືກເລືອກເພື່ອສ້າງໂຄງສ້າງເມັດພືດທີ່ລະອຽດອ່ອນທີ່ມີສຽງກົນຈັກຫຼາຍທີ່ສຸດ.
[1] ບໍ່ເຫມືອນກັບອັດຕາການ ramp-up ສູງສຸດ, ອັດຕາການ ramp-down ມັກຈະຖືກລະເລີຍ.ມັນອາດຈະເປັນວ່າອັດຕາການລ້າແມ່ນມີຄວາມສໍາຄັນຫນ້ອຍກວ່າອຸນຫະພູມທີ່ແນ່ນອນ, ແນວໃດກໍ່ຕາມ, ຄວາມຊັນທີ່ອະນຸຍາດໃຫ້ສູງສຸດສໍາລັບອົງປະກອບໃດກໍ່ຄວນນໍາໃຊ້ບໍ່ວ່າຈະເປັນອົງປະກອບຮ້ອນຫຼືເຢັນລົງ.ອັດຕາຄວາມເຢັນຂອງ 4°C/s ແມ່ນແນະນໍາທົ່ວໄປ.ມັນເປັນຕົວກໍານົດການທີ່ຈະພິຈາລະນາໃນເວລາທີ່ການວິເຄາະຜົນໄດ້ຮັບຂະບວນການ.
ຄໍາວ່າ "reflow" ແມ່ນໃຊ້ເພື່ອອ້າງອີງເຖິງອຸນຫະພູມຂ້າງເທິງທີ່ມະຫາຊົນແຂງຂອງໂລຫະປະສົມ solder ແນ່ນອນວ່າຈະລະລາຍ (ກົງກັນຂ້າມກັບພຽງແຕ່ອ່ອນລົງ).ຖ້າເຢັນຕ່ໍາກວ່າອຸນຫະພູມນີ້, ແຜ່ນ solder ຈະບໍ່ໄຫຼ.ອົບອຸ່ນຢູ່ເຫນືອມັນອີກເທື່ອຫນຶ່ງ, solder ຈະໄຫຼອີກເທື່ອຫນຶ່ງ - ເພາະສະນັ້ນ "ການໄຫຼຄືນ".
ເຕັກນິກການປະກອບວົງຈອນທີ່ທັນສະໄຫມທີ່ໃຊ້ reflow soldering ບໍ່ຈໍາເປັນຕ້ອງອະນຸຍາດໃຫ້ solder ໄຫຼຫຼາຍກ່ວາຫນຶ່ງຄັ້ງ.ພວກເຂົາເຈົ້າຮັບປະກັນວ່າ solder granulated ທີ່ມີຢູ່ໃນ solder paste surpasses ອຸນຫະພູມ reflow ຂອງ solder ທີ່ກ່ຽວຂ້ອງ.
ການສ້າງໂປຣໄຟລ໌ຄວາມຮ້ອນ

ການສະແດງກຣາຟຟິກຂອງ Process Window Index ສໍາລັບໂປຣໄຟລ໌ຄວາມຮ້ອນ.
ໃນອຸດສາຫະກໍາການຜະລິດເອເລັກໂຕຣນິກ, ມາດຕະການສະຖິຕິ, ເອີ້ນວ່າ Process Window Index (PWI) ແມ່ນໃຊ້ເພື່ອປະເມີນຄວາມແຂງແຮງຂອງຂະບວນການຄວາມຮ້ອນ.PWI ຊ່ວຍວັດແທກວ່າຂະບວນການ "ພໍດີ" ເຂົ້າໄປໃນຂອບເຂດຈໍາກັດຂະບວນການທີ່ຜູ້ໃຊ້ກໍານົດເອງທີ່ເອີ້ນວ່າຂອບເຂດຈໍາກັດສະເພາະ.
ສູນກາງຂອງປ່ອງຢ້ຽມຂະບວນການຖືກກໍານົດເປັນສູນ, ແລະຂອບທີ່ສຸດຂອງປ່ອງຢ້ຽມຂະບວນການເປັນ 99%.A PWI ຫຼາຍກວ່າຫຼືເທົ່າກັບ 100% ຊີ້ໃຫ້ເຫັນວ່າໂປຣໄຟລ໌ບໍ່ໄດ້ປະມວນຜົນຜະລິດຕະພັນພາຍໃນສະເພາະ.PWI ຂອງ 99% ຊີ້ໃຫ້ເຫັນວ່າໂປຣໄຟລ໌ປະມວນຜົນຜະລິດຕະພັນພາຍໃນສະເພາະ, ແຕ່ແລ່ນຢູ່ຂອບຂອງປ່ອງຢ້ຽມຂະບວນການ.PWI ຂອງ 60% ຊີ້ບອກໂປຣໄຟລ໌ໃຊ້ 60% ຂອງຂໍ້ມູນສະເພາະຂະບວນການ.ໂດຍການນໍາໃຊ້ຄ່າ PWI, ຜູ້ຜະລິດສາມາດກໍານົດວິທີການຫຼາຍຂອງປ່ອງຢ້ຽມຂະບວນການທີ່ profile ຄວາມຮ້ອນໂດຍສະເພາະໃຊ້.ຄ່າ PWI ຕ່ໍາສະແດງເຖິງໂປຣໄຟລ໌ທີ່ເຂັ້ມແຂງກວ່າ.
ສໍາລັບປະສິດທິພາບສູງສຸດ, ຄ່າ PWI ແຍກຕ່າງຫາກແມ່ນຄິດໄລ່ສໍາລັບຂະບວນການສູງສຸດ, ຄວາມຊັນ, reflow, ແລະແຊ່ຂອງໂປຣໄຟລ໌ຄວາມຮ້ອນ.ເພື່ອຫຼີກເວັ້ນຄວາມເປັນໄປໄດ້ຂອງອາການຊ໊ອກຄວາມຮ້ອນທີ່ສົ່ງຜົນກະທົບຕໍ່ຜົນຜະລິດ, ຄວາມຊັນທີ່ຊັນທີ່ສຸດໃນໂປຣໄຟລ໌ຄວາມຮ້ອນຕ້ອງໄດ້ຮັບການກໍານົດແລະລະດັບ.ຜູ້ຜະລິດໃຊ້ຊອບແວທີ່ສ້າງຂຶ້ນເອງເພື່ອກໍານົດຢ່າງຖືກຕ້ອງແລະຫຼຸດລົງຄວາມຊັນຂອງຄວາມຊັນ.ນອກຈາກນັ້ນ, ຊອບແວຍັງ recalibrate ຄ່າ PWI ອັດຕະໂນມັດສໍາລັບຂະບວນການສູງສຸດ, ຄວາມຊັນ, reflow, ແລະແຊ່.ໂດຍການກໍານົດຄ່າ PWI, ວິສະວະກອນສາມາດຮັບປະກັນວ່າການເຮັດວຽກ reflow soldering ບໍ່ overheat ຫຼືເຢັນໄວເກີນໄປ.
ເວລາປະກາດ: ວັນທີ 01-01-2022

