リフローはんだ付けは、はんだペースト (粉末はんだとフラックスの粘着性のある混合物) を使用して 1 つまたは複数の電気部品をコンタクト パッドに一時的に取り付け、その後アセンブリ全体を制御された熱にさらしてはんだを溶かすプロセスです。 、ジョイントを永久的に接続します。加熱は、アセンブリをリフローオーブンに通すか赤外線ランプの下に通すか、熱風ペンシルで個々の接合部をはんだ付けすることによって行うことができます。
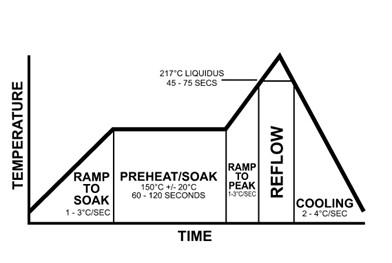
リフローはんだ付けは、表面実装部品を回路基板に取り付ける最も一般的な方法ですが、穴をはんだペーストで埋めて部品のリード線をペーストに挿入することで、スルーホール部品にも使用できます。ウェーブはんだ付けはより簡単で安価であるため、リフローは通常、純粋なスルーホール基板には使用されません。SMT コンポーネントと THT コンポーネントが混在する基板で使用すると、スルーホール リフローによって組み立てプロセスからウェーブはんだ付けステップが排除され、組み立てコストが削減される可能性があります。
リフロープロセスの目的は、電気部品を過熱して損傷することなく、はんだを溶かして隣接する表面を加熱することです。従来のリフローはんだ付けプロセスには通常、「ゾーン」と呼ばれる 4 つの段階があり、それぞれが予熱、サーマルソーク (単にソークと短縮されることもよくあります)、リフロー、および冷却という明確な熱プロファイルを持っています。
予熱ゾーン
最大傾きは、プリント基板上の温度がどれだけ速く変化するかを測定する温度と時間の関係です。予熱ゾーンはゾーンの中で最も長いことが多く、ランプレートを確立することがよくあります。通常、上昇率は 1 秒あたり 1.0 °C ~ 3.0 °C の間で、多くの場合 1 秒あたり 2.0 °C ~ 3.0 °C (4 °F ~ 5 °F) の間で低下します。速度が最大傾きを超えると、熱衝撃によるコンポーネントの損傷や亀裂が発生する可能性があります。
はんだペーストも飛散の影響を与える可能性があります。予熱セクションは、ペースト内の溶剤が蒸発し始める場所であり、上昇速度 (または温度レベル) が低すぎる場合、フラックス揮発性物質の蒸発が不完全になります。
サーマルソークゾーン
2 番目のセクションである熱浸漬は、通常、はんだペーストの揮発性物質を除去し、フラックス (フラックスを参照) を活性化するために 60 ~ 120 秒間さらされ、フラックス成分がコンポーネントのリードおよびパッド上で酸化物還元を開始します。温度が高すぎると、はんだの飛散やボール化が発生したり、ペースト、取り付けパッド、コンポーネントの端子が酸化したりする可能性があります。
同様に、温度が低すぎるとフラックスが完全に活性化しない可能性があります。均熱ゾーンの終わりでは、リフローゾーンの直前にアセンブリ全体の熱平衡が求められます。さまざまなサイズのコンポーネント間のデルタ T を減少させるため、または PCB アセンブリが非常に大きい場合は、浸漬プロファイルを使用することをお勧めします。エリアアレイタイプのパッケージのボイドを減らすために、ソークプロファイルも推奨されます。
リフローゾーン
3 番目のセクションであるリフロー ゾーンは、「リフロー以上の時間」または「液相線以上の時間」(TAL) とも呼ばれ、プロセスの中で最高温度に達する部分です。重要な考慮事項は、プロセス全体の最大許容温度であるピーク温度です。一般的なピーク温度は、液相線より 20 ~ 40 °C 高い温度です。この制限は、高温耐性が最も低いアセンブリ上のコンポーネント (熱損傷の影響を最も受けやすいコンポーネント) によって決まります。標準的なガイドラインは、最も脆弱なコンポーネントがプロセスの最高温度に達するまでに維持できる最高温度から 5 °C を差し引くことです。プロセス温度がこの制限を超えないよう監視することが重要です。
さらに、高温 (260 °C を超える) は、金属間化合物の成長を促進するだけでなく、SMT コンポーネントの内部ダイに損傷を与える可能性があります。逆に、温度が十分に高くないと、ペーストが適切にリフローできない可能性があります。
液相線以上の時間 (TAL) またはリフロー以上の時間は、はんだが液体である時間を測定します。フラックスは金属の接合部の表面張力を低下させて冶金学的結合を実現し、個々のはんだ粉末球が結合できるようにします。プロファイル時間がメーカーの仕様を超えると、フラックスの早期活性化または消費が生じ、はんだ接合部の形成前にペーストが効果的に「乾燥」する可能性があります。時間と温度の関係が不十分であると、フラックスの洗浄作用が低下し、その結果、濡れが悪くなり、溶剤やフラックスの除去が不十分になり、はんだ接合部に欠陥が生じる可能性があります。
専門家は通常、可能な限り短い TAL を推奨しますが、ほとんどのペーストでは最小 TAL を 30 秒と指定していますが、その特定の時間に明確な理由はないようです。考えられる可能性の 1 つは、PCB 上にプロファイリング中に測定されない場所があるため、最小許容時間を 30 秒に設定することで、測定されていない領域がリフローしない可能性を減らすことです。最小リフロー時間が長いと、オーブンの温度変化に対する安全マージンも得られます。湿潤時間は、液相線上で 60 秒未満に抑えるのが理想的です。液相線を超える時間がさらに長くなると、過剰な金属間化合物の成長が発生し、接合部の脆化につながる可能性があります。基板とコンポーネントは、液相線により長時間にわたって損傷を受ける可能性もあり、ほとんどのコンポーネントには、所定の最大値を超える温度にさらされる時間について明確に定義された制限時間があります。
液相線を超える時間が短すぎると、溶剤やフラックスが閉じ込められ、接合部が冷えたり鈍くなったり、はんだボイドが発生したりする可能性があります。
冷却ゾーン
最後のゾーンは、加工された基板を徐々に冷却し、はんだ接合部を固化させる冷却ゾーンです。適切な冷却により、過剰な金属間化合物の形成やコンポーネントへの熱衝撃が抑制されます。冷却ゾーンの通常の温度は 30 ~ 100 °C (86 ~ 212 °F) の範囲です。機械的に最も健全な微細粒子構造を作成するために、速い冷却速度が選択されます。
[1] 最大ランプアップ レートとは異なり、ランプダウン レートは無視されることがよくあります。特定の温度を超えるとランプ速度はそれほど重要ではなくなる可能性がありますが、コンポーネントが加熱しているか冷却しているかに関係なく、コンポーネントの最大許容勾配を適用する必要があります。通常、4℃/秒の冷却速度が推奨されます。これは、プロセス結果を分析する際に考慮すべきパラメータです。
「リフロー」という用語は、はんだ合金の固体の塊が(単に軟化するのではなく)確実に溶ける温度を指すために使用されます。この温度以下に冷却すると、はんだは流れなくなります。その上でもう一度温めると、はんだは再び流れます。したがって、「リフロー」となります。
リフローはんだ付けを使用する最新の回路アセンブリ技術では、必ずしもはんだを複数回流すことができるわけではありません。はんだペーストに含まれる粒状はんだが、はんだのリフロー温度を超えることを保証します。
熱プロファイリング

熱プロファイルのプロセス ウィンドウ インデックスのグラフ表示。
エレクトロニクス製造業界では、熱プロセスの堅牢性を定量化するために、プロセス ウィンドウ インデックス (PWI) として知られる統計的尺度が使用されます。PWI は、仕様限界として知られるユーザー定義のプロセス限界にプロセスがどの程度「適合」するかを測定するのに役立ちます。各熱プロファイルは、プロセス ウィンドウ (仕様または許容限界) にどのように「適合」するかによってランク付けされます。
プロセス ウィンドウの中心はゼロ、プロセス ウィンドウの端は 99% として定義されます。100% 以上の PWI は、プロファイルが仕様内で製品を処理していないことを示します。PWI が 99% の場合、プロファイルは仕様内で製品を処理しますが、プロセス ウィンドウの端で実行されることを示します。60% の PWI は、プロファイルがプロセス仕様の 60% を使用していることを示します。PWI 値を使用することで、メーカーは特定の熱プロファイルが使用するプロセス ウィンドウの量を決定できます。PWI 値が低いほど、プロファイルがより堅牢であることを示します。
効率を最大化するために、熱プロファイルのピーク、スロープ、リフロー、ソーク プロセスに対して個別の PWI 値が計算されます。熱衝撃が出力に影響を与える可能性を回避するには、熱プロファイルの最も急な勾配を決定し、平準化する必要があります。メーカーは、特注のソフトウェアを使用して、斜面の急勾配を正確に判断し、緩和します。さらに、ソフトウェアはピーク、スロープ、リフロー、ソークプロセスの PWI 値を自動的に再校正します。PWI 値を設定することで、エンジニアはリフローはんだ付け作業が過熱したり、急激に冷却されたりしないようにすることができます。
投稿時間: 2022 年 3 月 1 日

