Ang reflow soldering ay isang proseso kung saan ang isang solder paste (isang malagkit na pinaghalong powdered solder at flux) ay ginagamit upang pansamantalang ikabit ang isa o ilang mga de-koryenteng bahagi sa kanilang mga contact pad, pagkatapos nito ang buong pagpupulong ay sumasailalim sa kinokontrol na init, na natutunaw ang panghinang. , permanenteng kumokonekta sa joint.Maaaring maisagawa ang pag-init sa pamamagitan ng pagpasa sa assembly sa pamamagitan ng reflow oven o sa ilalim ng infrared lamp o sa pamamagitan ng paghihinang ng mga indibidwal na joints gamit ang hot air pencil.
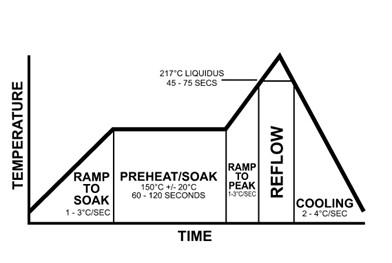
Ang reflow soldering ay ang pinakakaraniwang paraan ng pag-attach ng mga surface mount component sa isang circuit board, bagama't maaari din itong gamitin para sa through-hole na mga bahagi sa pamamagitan ng pagpuno sa mga butas ng solder paste at pagpasok ng component leads sa pamamagitan ng paste.Dahil ang wave soldering ay maaaring maging mas simple at mas mura, ang reflow ay hindi karaniwang ginagamit sa purong through-hole boards.Kapag ginamit sa mga board na naglalaman ng halo ng mga bahagi ng SMT at THT, ang through-hole reflow ay nagbibigay-daan sa wave soldering step na maalis mula sa proseso ng pagpupulong, na posibleng makabawas sa mga gastos sa pagpupulong.
Ang layunin ng proseso ng reflow ay tunawin ang panghinang at painitin ang magkadugtong na mga ibabaw, nang hindi nag-overheat at nakakapinsala sa mga de-koryenteng bahagi.Sa kumbensyonal na proseso ng paghihinang ng reflow, karaniwang may apat na yugto, na tinatawag na "mga zone", bawat isa ay may natatanging thermal profile: preheat, thermal soak (madalas na pinaikli sa ibabad lamang), reflow, at paglamig.
Painitin muna ang zone
Ang maximum na slope ay isang relasyon sa temperatura/oras na sumusukat kung gaano kabilis ang pagbabago ng temperatura sa naka-print na circuit board.Ang preheat zone ay kadalasang pinakamahaba sa mga zone at kadalasang nagtatatag ng ramp-rate.Ang rate ng ramp-up ay karaniwang nasa pagitan ng 1.0 °C at 3.0 °C bawat segundo, kadalasang bumababa sa pagitan ng 2.0 °C at 3.0 °C (4 °F hanggang 5 °F) bawat segundo.Kung ang rate ay lumampas sa pinakamataas na slope, ang pinsala sa mga bahagi mula sa thermal shock o crack ay maaaring mangyari.
Ang solder paste ay maaari ding magkaroon ng spattering effect.Ang seksyon ng preheat ay kung saan ang solvent sa paste ay nagsisimulang mag-evaporate, at kung ang pagtaas ng rate (o antas ng temperatura) ay masyadong mababa, ang evaporation ng flux volatiles ay hindi kumpleto.
Thermal soak zone
Ang pangalawang seksyon, ang thermal soak, ay karaniwang isang 60 hanggang 120 segundong pagkakalantad para sa pagtanggal ng solder paste volatiles at pag-activate ng mga flux (tingnan ang flux), kung saan ang mga bahagi ng flux ay nagsisimula sa pagbabawas ng oxide sa mga lead at pad ng bahagi.Ang masyadong mataas na temperatura ay maaaring humantong sa pag-solder spattering o balling pati na rin ang oksihenasyon ng paste, ang mga attachment pad at ang mga pagwawakas ng bahagi.
Katulad nito, maaaring hindi ganap na mag-activate ang mga flux kung masyadong mababa ang temperatura.Sa dulo ng soak zone, isang thermal equilibrium ng buong assembly ang nais bago ang reflow zone.Iminumungkahi ang isang soak profile upang bawasan ang anumang delta T sa pagitan ng mga bahagi na may iba't ibang laki o kung ang PCB assembly ay napakalaki.Inirerekomenda din ang isang babad na profile upang mabawasan ang voiding sa mga pakete ng uri ng array ng lugar.
Reflow zone
Ang ikatlong seksyon, ang reflow zone, ay tinutukoy din bilang "time above reflow" o "time above liquidus" (TAL), at ito ang bahagi ng proseso kung saan naabot ang pinakamataas na temperatura.Ang isang mahalagang pagsasaalang-alang ay ang peak temperature, na siyang pinakamataas na pinapayagang temperatura ng buong proseso.Ang karaniwang peak temperature ay 20–40 °C sa itaas ng liquidus. Ang limitasyong ito ay tinutukoy ng component sa assembly na may pinakamababang tolerance para sa matataas na temperatura (Ang component na pinaka-madaling kapitan sa thermal damage).Ang isang karaniwang patnubay ay ang pagbabawas ng 5 °C mula sa pinakamataas na temperatura na maaaring mapanatili ng pinaka-mahina na bahagi upang makarating sa pinakamataas na temperatura para sa proseso.Mahalagang subaybayan ang temperatura ng proseso upang hindi ito lumampas sa limitasyong ito.
Bukod pa rito, ang mataas na temperatura (lampas sa 260 °C) ay maaaring magdulot ng pinsala sa panloob na pagkamatay ng mga bahagi ng SMT pati na rin ang pagsulong ng intermetallic growth.Sa kabaligtaran, ang isang temperatura na hindi sapat na init ay maaaring pumigil sa pag-paste mula sa muling pagdaloy nang maayos.
Ang oras sa itaas ng liquidus (TAL), o oras sa itaas ng reflow, ay sumusukat kung gaano katagal ang solder ay isang likido.Ang pagkilos ng bagay ay binabawasan ang pag-igting sa ibabaw sa magkasanib na mga metal upang magawa ang metalurhiko na pagbubuklod, na nagpapahintulot sa mga indibidwal na solder powder spheres na pagsamahin.Kung ang oras ng profile ay lumampas sa detalye ng tagagawa, ang resulta ay maaaring maagang pag-activate ng flux o pagkonsumo, na epektibong "pagpatuyo" ng i-paste bago ang pagbuo ng solder joint.Ang isang hindi sapat na relasyon sa oras/temperatura ay nagdudulot ng pagbaba sa pagkilos ng paglilinis ng flux, na nagreresulta sa mahinang basa, hindi sapat na pag-alis ng solvent at flux, at posibleng may sira na mga joint ng solder.
Karaniwang inirerekomenda ng mga eksperto ang pinakamaikling TAL na posible, gayunpaman, ang karamihan sa mga paste ay tumutukoy ng pinakamababang TAL na 30 segundo, bagama't mukhang walang malinaw na dahilan para sa partikular na oras na iyon.Ang isang posibilidad ay mayroong mga lugar sa PCB na hindi nasusukat sa panahon ng pag-profile, at samakatuwid, ang pagtatakda ng pinakamababang pinapayagang oras sa 30 segundo ay binabawasan ang pagkakataon ng hindi nasusukat na lugar na hindi muling dumaloy.Ang mataas na minimum na reflow time ay nagbibigay din ng margin ng kaligtasan laban sa mga pagbabago sa temperatura ng oven.Ang oras ng pagbabasa ay perpektong nananatili sa ibaba ng 60 segundo sa itaas ng liquidus.Ang karagdagang oras sa itaas ng liquidus ay maaaring magdulot ng labis na intermetallic growth, na maaaring humantong sa pagkasira ng magkasanib na bahagi.Ang board at mga bahagi ay maaari ding masira sa mga pinalawig na oras sa paglipas ng liquidus, at karamihan sa mga bahagi ay may mahusay na tinukoy na limitasyon sa oras kung gaano katagal sila maaaring malantad sa mga temperatura sa isang ibinigay na maximum.
Ang masyadong maliit na oras sa itaas ng liquidus ay maaaring ma-trap ang mga solvent at flux at lumikha ng potensyal para sa malamig o mapurol na mga joints pati na rin ang mga solder void.
Cooling zone
Ang huling zone ay isang cooling zone upang unti-unting palamig ang naprosesong board at patatagin ang mga solder joints.Ang wastong paglamig ay pumipigil sa sobrang intermetallic formation o thermal shock sa mga bahagi.Ang mga karaniwang temperatura sa cooling zone ay mula 30–100 °C (86–212 °F).Pinipili ang isang mabilis na rate ng paglamig upang lumikha ng isang pinong istraktura ng butil na pinaka mekanikal na tunog.
[1] Hindi tulad ng pinakamataas na rate ng ramp-up, ang rate ng ramp-down ay kadalasang binabalewala.Maaaring ang rate ng ramp ay hindi gaanong kritikal sa ilang partikular na temperatura, gayunpaman, ang maximum na pinapahintulutang slope para sa anumang bahagi ay dapat ilapat kung ang bahagi ay umiinit o lumalamig.Karaniwang iminumungkahi ang rate ng paglamig na 4°C/s.Isa itong parameter na dapat isaalang-alang kapag sinusuri ang mga resulta ng proseso.
Ang terminong "reflow" ay ginagamit upang tumukoy sa temperatura sa itaas kung saan ang isang solidong masa ng solder alloy ay tiyak na matutunaw (kumpara sa lumalambot lamang).Kung pinalamig sa ibaba ng temperatura na ito, ang panghinang ay hindi dadaloy.Kapag pinainit muli, ang panghinang ay dadaloy muli—kaya "muling dumaloy".
Ang mga makabagong pamamaraan ng pagpupulong ng circuit na gumagamit ng reflow soldering ay hindi kinakailangang payagan ang solder na dumaloy nang higit sa isang beses.Ginagarantiyahan nila na ang granulated solder na nakapaloob sa solder paste ay lumalampas sa reflow temperature ng solder na kasangkot.
Thermal profiling

Isang graphical na representasyon ng Process Window Index para sa isang thermal profile.
Sa industriya ng pagmamanupaktura ng electronics, ang isang istatistikal na panukala, na kilala bilang Process Window Index (PWI) ay ginagamit upang mabilang ang tibay ng isang thermal na proseso.Tumutulong ang PWI na sukatin kung gaano kahusay ang isang proseso "naaangkop" sa isang limitasyon ng proseso na tinukoy ng gumagamit na kilala bilang ang Specification Limit. Ang bawat thermal profile ay niraranggo sa kung paano ito "naaangkop" sa isang window ng proseso (ang detalye o limitasyon sa pagpapaubaya).
Ang sentro ng window ng proseso ay tinukoy bilang zero, at ang matinding gilid ng window ng proseso bilang 99%.Ang isang PWI na mas malaki kaysa sa o katumbas ng 100% ay nagpapahiwatig na ang profile ay hindi nagpoproseso ng produkto sa loob ng detalye.Ang isang PWI na 99% ay nagpapahiwatig na ang profile ay nagpoproseso ng produkto sa loob ng detalye, ngunit tumatakbo sa gilid ng window ng proseso.Ang isang PWI na 60% ay nagpapahiwatig na ang isang profile ay gumagamit ng 60% ng detalye ng proseso.Sa pamamagitan ng paggamit ng mga halaga ng PWI, matutukoy ng mga tagagawa kung gaano karami sa window ng proseso ang ginagamit ng isang partikular na thermal profile.Ang isang mas mababang halaga ng PWI ay nagpapahiwatig ng isang mas matatag na profile.
Para sa maximum na kahusayan, ang mga hiwalay na halaga ng PWI ay kinukuwenta para sa mga proseso ng peak, slope, reflow, at soak ng isang thermal profile.Upang maiwasan ang posibilidad ng thermal shock na makakaapekto sa output, ang pinakamatarik na slope sa thermal profile ay dapat matukoy at ma-level.Gumagamit ang mga tagagawa ng custom-built na software upang tumpak na matukoy at bawasan ang tirik ng slope.Bilang karagdagan, ang software ay awtomatikong muling nag-recalibrate sa mga halaga ng PWI para sa mga proseso ng peak, slope, reflow, at soak.Sa pamamagitan ng pagtatakda ng mga halaga ng PWI, matitiyak ng mga inhinyero na ang gawaing paghihinang ng reflow ay hindi masyadong uminit o masyadong lumalamig.
Oras ng post: Mar-01-2022

